해석배경
Probe Card는 전자 테스트 시스템과 반도체 웨이퍼 사이의 인터페이스로 인쇄 회로 기판(PCB)과 일부 형태의 접촉 요소로 구성됩니다. Probe Card는 Wafer Prober에 삽입되며, 그 내부에서 Prober와 Wafer 사이에 접촉에 정확하게 이루어지도록 Wafer의 위치를 조정하며 실험을 진행합니다. 이때 Probe Card의 효율은 Probe Card와 Wafer사이의 접촉부를 변형 시킬 수 있는 여러 요인 중 온도로 인한 변형과 이로 웨이퍼의 밀림현상 중점으로 분석합니다.
해석목적
• Wafer Probe Card의 열변형 평가 및 정밀도 확보
• Wafer의 밀림현상 해석

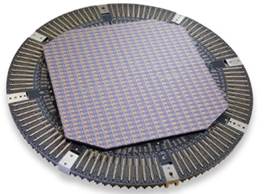
Wafer Probe Card 및 Wafer 이미지
해석모델 및 해석조건
Wafer Probe Card열 해석
• 절점온도 : 90℃
• 외기온도 : 20℃
• 자연대류 경계조건 적용
• 하중조건 :
- 각 Hole에 10g 하중적용
- 전체 절점에 대하여 각 절점의 온도하중 적용
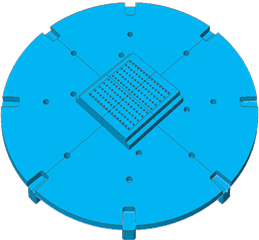
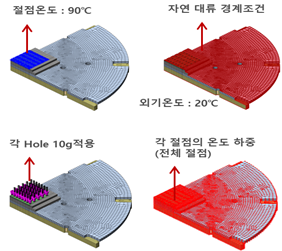
Wafer Probe Card의 CAD 모델(좌) - FE모델 (우)
Wafer 선형정적해석
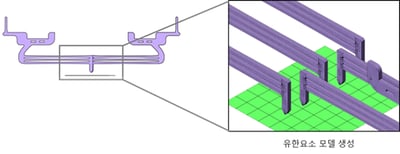
해석결과
Wafer Probe Card 열응력/열전달해석
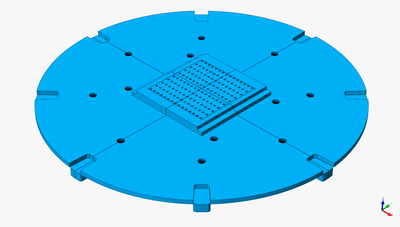
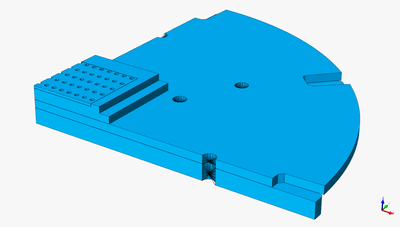
Wafer Probe Card의 온도분포
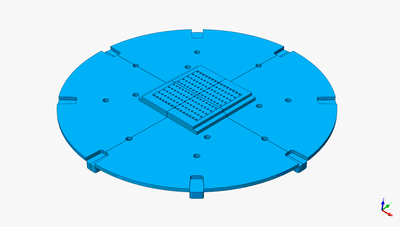

Wafer Probe Card의 응력분포
Wafer 선형정적해석
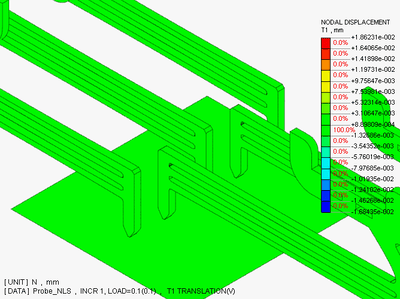
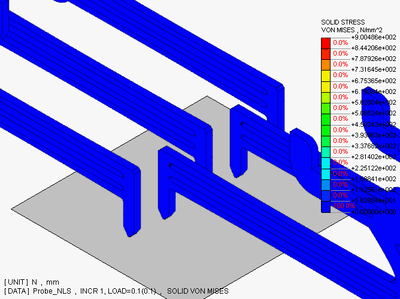
수평변위의 변위 분포(좌) - 응력 분포(우)
설계자가 사용하는
설계 단계 CAE 솔루션 MeshFree
설계 단계 CAE 솔루션 MeshFree
제품 자세히 보기
유익한 CAE 기술소식 반디통 사이트반디통 바로가기
해석타입 태그
- NFX STR (37)
- NFX CFD (7)
- NFX STR (7)
- NFX CFD (5)
- mts (4)
- 구조해석 (3)
- 유동해석 (3)
- Meshfree (2)
- 전기회로 (2)
- 1D-Flow (1)
- 1차원-유동 (1)
- MRF (1)
- Mesh (1)
- MeshFree (1)
- mapping (1)
- 가이드베인 (1)
- 구조해석 (1)
- 글라스 (1)
- 내진설계 (1)
- 다상유동 (1)
- 모드해석 (1)
- 물질확산 (1)
- 벌칙기법 (1)
- 비선형해석 (1)
- 사용자정의함수 (1)
- 사이펀 (1)
- 상대습도 (1)
- 스프링 요소 (1)
- 슬롯다이코팅 (1)
- 열변형해석 (1)
- 열유동해석 (1)
- 열전달 (1)
- 요소 (1)
- 요소망변형 (1)
- 요소품질 (1)
- 위상최적설계 (1)
- 위상최적화 (1)
- 응답스펙트럼 (1)
- 전자장비냉각 (1)
- 접촉해석 (1)
- 줄발열 (1)
- 처짐해석 (1)
- 체적분율 (1)
- 펌프 (1)
- 혼합면 (1)
- 회전체 (1)